由于輕薄短小已經成為電子消費品的發展方向,既能省掉材料及工序,又能縮少元器件尺寸的晶圓級封裝工藝,已經越來越普遍了。
晶圓級封裝可分為扇入型及扇出型,如果封裝后的芯片尺寸和產品尺寸在二維平面上是一樣大,芯片有足夠的面積把所有的 I/O 接口都放進去,就會采用扇入型。
如果芯片的尺寸不足以放下所有 I/O 接口時,就需要扇出型,當然一般的扇出型在面積擴展的同時也加了有源和/或無源器件以形成 SIP。
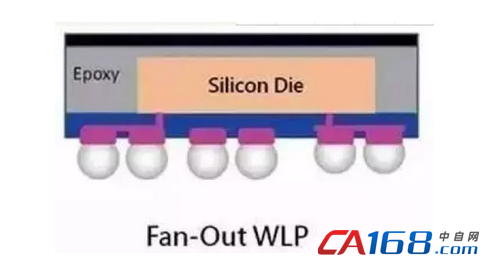
-
晶圓的制備及切割 – 將晶圓放入劃片膠帶中,切割成各個單元準備金屬載板 – 清潔載板及清除一切污染物
-
層壓粘合 – 通過壓力來激化粘合膜
-
重組晶圓 – 將芯片從晶圓拾取及放置在金屬載板上
-
制模 – 以制模復合物密封載板
-
移走載板 – 從載板上移走已成型的重建芯片
-
排列及重新布線 – 在再分布層上(RDL),提供金屬化工藝制造 I/O 接口
-
晶圓凸塊 – 在I/O外連接口形成凸塊
-
切割成各個單元 – 將已成型的塑封體切割
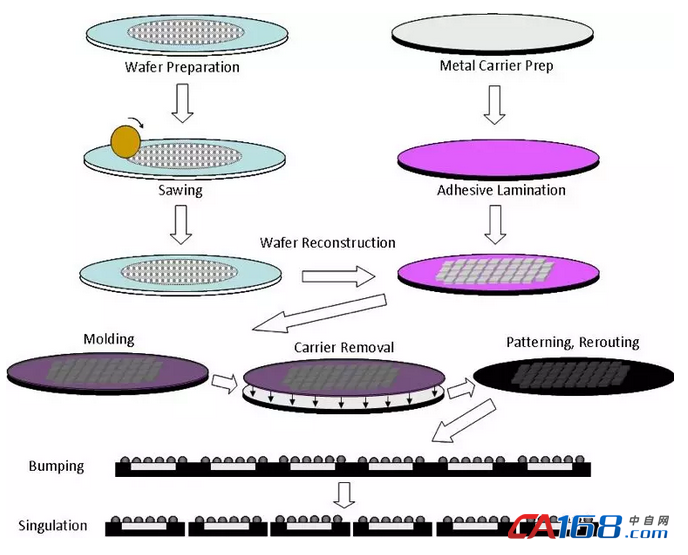
扇出型封裝“核心”市場,包括電源管理及射頻收發器等單芯片應用,一直保持穩定的增長趨勢。扇出型封裝“高密度”市場,包括處理器、存儲器等輸入輸出數據量更大的應用,市場潛力巨大。

環球儀器的FuzionSC貼片機,配合Innova直接晶圓送料器
具備以下優勢:
-
最高精度(±10微米)、最高速度、最大面積組裝
-
支持最大達610毫米 x813毫米的基板
-
支持由AOI精度返饋進行貼裝位置補償
-
軟件支持大量芯片的組裝
-
精準的物料處理及熱度階段選項
-
可采用SECS-GEM系統追蹤晶片

Innova的優點:
-
可直接導入倒裝芯片及晶圓級裸晶片來進行拾取及貼裝
-
可在同一平臺上進行倒裝芯片、裸晶片及表面貼裝工序
-
具備單一晶圓送料(Innova),或13個晶圓送料(Innova +)
-
無需上游晶圓分選
-
系統封裝應用的最佳方案
-
支持最大達300毫米的晶圓
-
支持墨水和無墨水晶圓片陣列測繪
-
支持最大達610毫米 x813毫米的基板
-
晶圓擴張深度:可編程(Innova +),由夾圈固定(Innova)
-
可直接導入倒裝或不倒裝芯片
-
具備晶片追蹤功能
-
新品導入或量產的最佳方案

-
-










共0條 [查看全部] 網友評論