
為了實現(xiàn)低碳社會,能夠高效電能變換的電力電子技術(shù)正在擴展到消費、工業(yè)、電氣化鐵路、汽車、太陽能發(fā)電和風(fēng)力發(fā)電等各個領(lǐng)域。其中,功率模塊在控制電流方面發(fā)揮著重要作用,需要減少運行過程中的損耗,減小封裝尺寸,并提高功率密度。近年來備受關(guān)注的SiC(碳化硅)與以往的Si(硅)相比具有高速開關(guān)且低損耗的特點,能夠飛躍性地提高性能,因此被期待為下一代的功率器件。此外,由于SiC能夠高溫工作,因此可以通過減小封裝尺寸來促進功率單元的小型化,但為此,需要開發(fā)能夠應(yīng)對高溫工作的封裝材料和結(jié)構(gòu)。
在封裝開發(fā)過程中,我們提高了鍵合材料和灌封材料等各部件的耐熱性,并開發(fā)了對應(yīng)的工藝技術(shù),特別是提高了對溫度循環(huán)壽命有影響的鍵合部位的可靠性,實現(xiàn)了高質(zhì)量和高可靠性。通過應(yīng)用這些技術(shù),我們開發(fā)了一種支持芯片工作溫度(Tjop)175℃高溫運行的封裝。
圖1顯示了開發(fā)的高溫工作全SiC功率模塊(FMF185/375/750DC-66A)的封裝外觀,圖2顯示了主要結(jié)構(gòu)(示意圖)。作為支持175℃高溫運行的封裝結(jié)構(gòu),在底板上使用耐高溫焊錫來連接耐高溫絕緣基板,在絕緣基板上使用Ag燒結(jié)技術(shù)鍵合芯片。芯片上面的電極和絕緣基板金屬層用Al線連接,與外部電氣連接的電極與絕緣基板金屬層進行US鍵合。外殼安裝在底板上,內(nèi)部填充了耐高溫灌封材料。
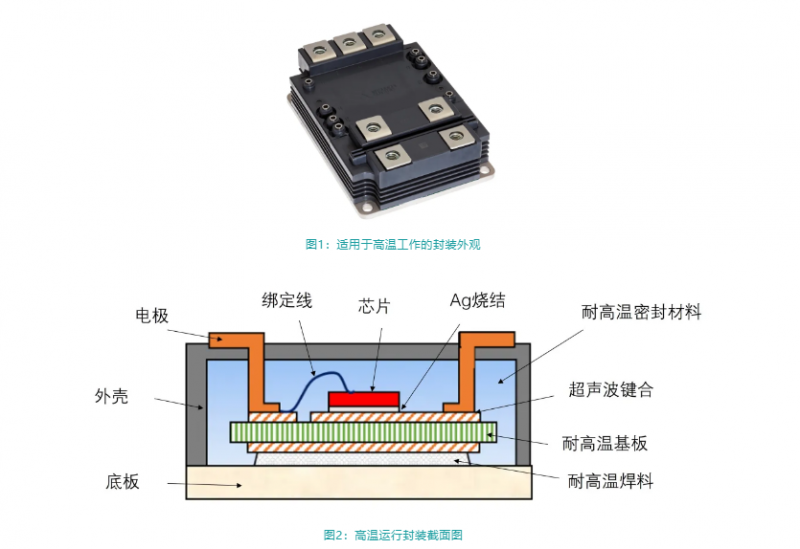















共0條 [查看全部] 網(wǎng)友評論