隨著決定超精細半導體工藝競爭力的極紫外(EUV)光刻設備重要性日益提升,三星電子、臺積電和英特爾三大代工廠對下一代設備的爭奪也愈加激烈。
此前一直猶豫是否采用下一代EUV設備的臺積電CEO,放棄了內部重大活動,飛赴荷蘭與ASML洽談設備,此舉標志著2納米以下超精細工藝的競爭拉開序幕。
據業界消息及外媒5月26日報道,臺積電CEO魏哲家缺席5月23日在臺灣臺北舉行的“臺積電技術研討會2024”,而是前往荷蘭埃因霍溫的ASML總部和德國迪琴根的工業激光專業公司通快(TRUMPF)。
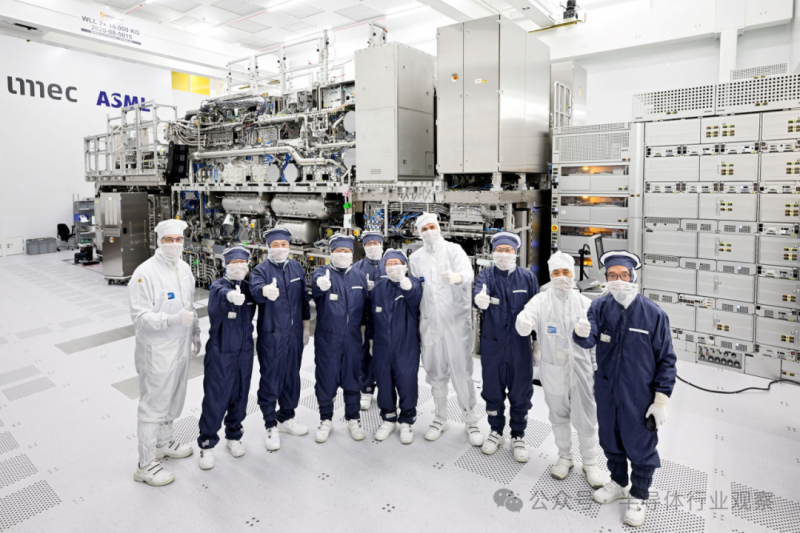
秘密出訪的魏哲家行蹤,被 ASML 執行長Christopher Fuke與通快執行長 Nicola Leibinger-Kammüller 在社交媒體曝光。Fuke執行長表示,“我們向魏總介紹了我們最新的技術、新產品,包括高數值孔徑 (High NA) EUV 設備如何實現未來的半導體微加工技術。”
臺灣當地媒體及業界人士分析稱,“看來臺積電管理層為了鞏固全球半導體霸主地位,決定性地訪問阿斯麥”,“隨著光刻設備在7納米以下超精細工藝中的重要性日益提升,臺積電似乎也加入了競爭”。據悉,臺積電正考慮在2026年下半年量產的1.6納米產品A16之后的工藝中引入High NA EUV設備,在此之前則使用現有的Low NA EUV設備。
去年,英特爾成為業內首家從 ASML 獲得高 NA EUV 設備的公司,此后爭奪 ASML 的競爭愈演愈烈。業界預計英特爾將在其 14A(1.4 納米)半導體工藝中充分利用高 NA EUV。
三星電子也積極行動。上個月 5 月 26 日,三星電子董事長李在镕在德國上科亨的蔡司總部會見了 ASML 首席執行官 Fuke 和 ASML 的重要合作伙伴卡爾蔡司首席執行官 Karl Lamprecht,以加強“三方半導體聯盟”。由于 EUV 不僅出現在 2 納米代工工藝中,而且也出現在最新的先進內存 (DRAM) 工藝中,三星電子也押注于引入High NA EUV。
EUV光刻,太貴了?
三星電子研究員 Young Seog Kang 表示,EUV 技術的使用壽命是有限的。最近,在 SPIE 高級光刻會議的小組討論中,Kang 表示,高數值孔徑 EUV 光刻將遇到“性能和成本問題”。研究人員指出雙重圖案和先進的封裝技術可以作為替代方案。小組中的其他人并不同意他的悲觀觀點。
Kang 的評論進一步豐富了12 月份開始的關于高 NA 成本效益的討論。三星的競爭對手似乎在這個問題上存在分歧,英特爾熱衷于接受它,而臺積電則并不著急。前者最近確認將于 2026 年開始量產高數值孔徑,而后者可能要等到2030 年。
ASML 表示,HighNA 的采用進展符合預期,并表示這“顯然是芯片制造商可用的最具成本效益的解決方案”。SPIE AL 小組成員、ASML 系統工程總監 Jan van Shoot 指出,要提高分辨率和擴展 EUV 的實用性,仍然需要采取一些措施。
英特爾看好High NA EUV
英特爾 CEO Pat Gelsinger之前接受采訪時表示,在高數值孔徑機器上投入這么多資金之前,公司會非常仔細地研究它。一臺 EUV 機器大約需要 2.5 億美元,一臺高數值孔徑機器大約需要 4 億美元,那么經濟有效嗎?我們已經非常仔細地研究過,雙圖案化與使用高數值孔徑單圖案化時的不同。得出的結論是,可以讓經濟學以及與之相關的事物發揮作用。
當然,現在你必須獲得那些你能夠獲得的更緊密的pitch的價值,但我們正在非常仔細地考慮它。我們認為與其他一些多重圖案技術和一些可以完成的自對準技術相比,它表現得很好。我們認為它會結合在一起,我們對此感到非常興奮。
當然,對于場尺寸(field size),如果你采用更大的場尺寸,這就會成為一個問題,我正在挑戰 ASML 和我的掩模制造團隊,讓我采用更大的掩模尺寸,這樣我們就可以恢復場尺寸,也許更大的掩模尺寸可以使 EUV 整體上更加經濟。確保經濟發展面臨著很大的壓力,因為其中一件事是,當我們進入 EUV 一代時,摩爾定律的經濟學停止了。我必須將經濟學重新納入摩爾定律,因此不僅要制造更快的晶體管、更低功率的晶體管,還要制造更便宜的晶體管。我們的首要任務是確保摩爾定律的經濟性處于 EUV 過渡的另一邊。
ASML也反駁不看好的觀點
ASML 現在回擊了SemiAnalysis分析師的批評,他們認為,至少對于一些芯片制造商來說,使用該公司的下一代高數值孔徑芯片制造工具幾乎沒有經濟意義。在最近接受Bits and Chips采訪時,該公司首席財務官表示,High-NA 正在步入正軌且健康發展,而分析公司低估了其收益。在該公司最近的財報電話會議上,ASML 首席執行官也回應了有關該報告的問題,稱新技術“顯然是邏輯和內存方面最具成本效益的解決方案”。
ASML 的 Twinscan EXE High-NA EUV 光刻工具對于生產小于 2nm 的下一代工藝技術至關重要。但它們也比現有的 Twinscan NXE Low-NA極紫外 (EUV) 光刻工具貴得多 ——有人說它們的成本在 3 億至 4 億美元之間。它們還具有其他特點,例如掩模版尺寸減半和尺寸較大,這也是一些分析師認為這些工具在經濟上不適用于所有生產線的部分原因。
正如人們所預料的那樣,ASML 不同意這一評估,該公司的首席財務官告訴Bits and Chips,訂單符合公司的預期,而 SemiAnalysis 低估了通過避免昂貴的雙重和四重圖案來降低工藝復雜性的價值。他還表示,人們可以簡單地與英特爾討論雙重圖案帶來的復雜性,以了解其中的困難,這指的是英特爾在 10 納米技術上的失敗,至少部分原因是缺乏 EUV 技術。事實上,英特爾是當今 High-NA 的主要客戶,最近收到了運送給客戶的第一臺 High-NA 機器的第一批零件。讓我們仔細看看這些問題。
雙重和四重圖案涉及多次重復曝光晶圓的同一層,以創建比通常情況下更小的特征,但它會帶來出現缺陷的機會,從而影響良率,并且比簡單地一步印刷該層的成本更高。
使用低數值孔徑工具進行雙重和四重圖案化的總體成本,以及與使用高數值孔徑工具進行的單一圖案化相比如何,似乎是 ASML 和分析師之間的主要爭論點之一。
到目前為止,讀者可能會問,如果低數值孔徑 EUV 工具可以通過使用雙圖案化和/或 圖案成形工具來實現與前者相同的關鍵尺寸,為什么高數值孔徑 EUV 會出現所有麻煩?事實上,英特爾正在將應用材料公司的 Centura Sculpta 圖案成形工具插入其英特爾 20A 流程中,以避免在某些情況下昂貴的 EUV 雙重圖案化。與此同時,Intel 18A 確實依賴于 Centura Sculpta 圖案成形和 Twinscan NXE 雙圖案化。
但 EUV 雙圖案可能并沒有那么糟糕。蘋果公司在其大眾市場產品中使用了臺積電的 N3B 工藝技術,據報道該技術使用了雙圖案技術,其中包括數億臺 iPhone 15 Pro 和基于 M3 的 Mac 電腦。
ASML 認為,實施雙圖案化會帶來某些缺點:EUV 雙圖案化會導致生產時間更長,產生更多缺陷發生的機會,并可能影響所生產芯片的性能變化。然而,憑借 EXE:5000 的 8 納米關鍵尺寸 (CD),芯片制造商可以簡化其制造流程。
晶圓廠當然了解使用高數值孔徑 EUV 掃描儀的優點和缺點,因此他們已經開始了研發工作。
ASML 在一份聲明中寫道:“我們的客戶將在 2024 年至 2025 年開始研發,并在 2025 年至 2026 年進入大批量生產。”
ASML 最近分享了有關其新型高數值孔徑機器的更多細節;以下是這些工具的工作原理概要。
ASML 的下一代 Twinscan EXE 具有 0.55 數值孔徑 (NA) 鏡頭,因此其分辨率將達到 8 納米(臨界尺寸),這標志著當前提供 13 納米分辨率的 EUV 工具的重大進步。這意味著它可以打印比使用低數值孔徑工具單次曝光小 1.7 倍的晶體管,從而實現高 2.9 倍的晶體管密度。低數值孔徑光刻系統可以實現類似的分辨率,盡管需要兩次曝光,并采用昂貴的雙圖案工藝。實現 8 納米的關鍵尺寸對于使用 3 納米以下工藝技術生產芯片至關重要,業界計劃在 2025 年至 2026 年間采用該技術。
高數值孔徑 EUV 的實施有望使晶圓廠能夠避開 EUV 雙圖案化的需求,簡化工藝,可能提高產量并降低成本。但它也帶來了很多挑戰。
與此同時,ASML的Twinscan EXE光刻工具配備了0.55 NA鏡頭,與現有機器完全不同。主要和明顯的區別確實是新的和更大的鏡頭。但適應更大的鏡頭需要更大的鏡子,這就是為什么 Twinscan EXE 工具還采用變形光學設計。
這種方法解決了較大的鏡子導致光線以更陡的角度照射掩模版的問題,從而降低了反射率并阻礙了圖案轉移到晶圓上。變形光學器件不是均勻地縮小圖案,而是以不同的方式放大圖案:在一個方向上放大 4 倍,在另一個方向上放大 8 倍。這減少了光在掩模版上的入射角,解決了反射率問題。此外,這種方法允許芯片制造商繼續使用標準尺寸的掩模版,從而最大限度地減少對半導體行業的影響。這種方法有一個問題:它將成像場的尺寸減半(從 33mm x 26mm 到 16.5mm x 26mm),通常稱為高數值孔徑掩模版尺寸減半。
成像視野尺寸減半促使芯片制造商修改芯片設計和生產策略。隨著高端 GPU 和 AI 加速器越來越多地挑戰標線/成像區域尺寸的限制,這一變化尤其重要。
由于其變形光學器件和曝光場的大小是 Twinscan NXE 系統的一半,Twinscan EXE 工具需要對每個晶圓執行兩倍的曝光,這使現有機器的生產率減半。為了保持(并最終提高)生產率,ASML 顯著提高了晶圓和掩模版臺的速度。EXE 的晶圓臺加速速度為 8g,是 NXE 的兩倍,而其標線臺加速速度為 32g,是 NXE 的四倍。
這一增強功能使 Twinscan EXE:5000(可以說,主要是一個測試系統)能夠以 20 mJ/cm² 的劑量每小時打印超過 185 個晶圓,超過 Twinscan NXE: 3600C 在相同劑量下打印 170 個晶圓的產量。ASML 計劃到 2025 年利用 Twinscan EXE:5200 工具將產量提高到每小時 220 片晶圓,以確保高數值孔徑技術在芯片制造中的經濟可行性。同時,新節點(即較低分辨率/關鍵尺寸)需要更高劑量,因此 Twinscan NXE: 3600D 將劑量增加到 30 mJ/cm²,盡管每小時處理 160 片晶圓。由于某種原因,ASML 沒有提及其 EXE 系統在 30 mJ/cm² 劑量下的性能。
ASML 的高數值孔徑 EUV Twinscan EXE 光刻機的物理尺寸比低數值孔徑 EUV Twinscan NXE 光刻機更大。現有且廣泛部署的 ASML Twinscan NXE 將光源放置在其下方,這需要非常具體的晶圓廠建筑配置,并且使維護這些工具變得更加困難。相比之下,高數值孔徑 Twinscan EXE 機器水平放置光源,簡化了晶圓廠的建設和維護,但需要更大的潔凈室空間。另一方面,這使得升級現有晶圓廠變得更加困難。
與此同時,臺積電已經擁有多個專為低數值孔徑 EUV Twinscan NXE 光刻機建造的工廠。將這些晶圓廠升級到高數值孔徑 Twinscan EXE 工具是一項復雜的任務。考慮到工具本身的成本、減半的掩模版尺寸、將這些工具安裝到現有晶圓廠外殼中的復雜性、現有低數值孔徑工具的良好性能,以及許多其他無法在一個故事的框架內考慮的具體因素,我們可以理解為什么 華興資本的分析師認為臺積電暫時 還沒有準備好采用High NA EUV工具 。
總而言之,高數值孔徑掃描儀的采用具有更高的分辨率、更大的尺寸和減半的曝光場,因此需要開發新的光刻膠、計量、薄膜材料、掩模、檢查工具,甚至可能建造新的晶圓廠外殼。從本質上講,向高數值孔徑工具的過渡將需要對新工具和支持基礎設施進行大量投資,因此采用并不簡單。 然而,高數值孔徑 EUV 是未來,在我們看到有多少芯片制造商將這些工具投入生產以及何時投入生產之前,大規模部署在經濟上是否可行的問題無法得到明確答案。










共0條 [查看全部] 網友評論