// 講座概述
本系列講座旨在分享功率半導體的原理和相關應用知識,已發布的第1-30講主要介紹了功率半導體的基礎知識。從第31講起為大家介紹HVIGBT的一系列相關知識,以幫助讀者全面了解HVIGBT的工作原理、特性和正確應用方法。
對于電氣設備調試階段以及市場中退回的故障品進行器件深入分析,可以幫助我們找到HVIGBT發生失效的可能原因。由于造成HVIGBT失效的原因很多,通常我們使用故障樹分析(FTA, Fault Tree Analysis)的方法來協助我們快速查找原因,如下表9.1所示:
表9.1 HVIGBT故障分析樹
首先,我們根據失效的HVIGBT,初步得到可能的失效原因,按照表9.1所示,從上到下,從左到右依次查找,最終找到失效的原因。同時,三菱電機功率器件制作所經常通過設定實驗條件,對功率模塊進行故意破壞。根據實驗結果,建立失效模式數據庫。基于數據庫,幫助客戶分析可能的失效原因。
HVIGBT的過電壓失效包含兩類:VCE過電壓和VGE過電壓。VCE過電壓失效的位置在芯片的邊緣處,靠近場限環。如圖9.1所示。
圖9.1 VCE過電壓失效
-
HVIGBT在關斷時,由于電路回路中存在雜散電感,關斷瞬間會產生尖峰電壓,如果尖峰電壓超過HVIGBT的額定電壓,將可能造成HVIGBT擊穿損壞。
-
關斷電阻選擇過小,小于HVIGBT的規格書推薦值。
-
吸收電路不合理,吸收電路未能有效抑制HVIGBT關斷時的電壓尖峰,反而增大電壓尖峰。
VGE過電壓失效的位置在柵極絕緣區域。破壞部位可能位于芯片任意部位,因為柵極氧化層幾乎覆蓋了整個HVIGBT芯片的表面。如圖9.2所示。VGE過電壓失效點在IGBT硅片表面并不明顯,圖9.2是用顯微鏡觀測到的。

圖9.2 VGE過電壓失效IGBT在運行過程中,若出現窄脈沖,會對IGBT造成較大影響,甚至損壞。主要是因為內部IGBT在未完全開通情況下又重新關斷,這一過程產生的di/dt要比正常完全開通再關斷的情況大很多,這個大的di/dt又會產生高的關斷尖峰電壓,所以增大了HVIGBT過壓失效的風險。圖9.3給出了窄脈沖關斷和正常關斷di/dt的對比波形,可以看到兩者的di/dt和VCE(peak)值相差很大。
(b)正常關斷
圖9.3 IGBT在窄脈沖關斷和正常關斷下的對比波形
在二極管導通過程中,若出現窄脈沖,會對二極管的反向恢復過程產生較大影響。影響之一就是二極管反向恢復的電壓dv/dt會比正常反向恢復要大很多,dv/dt越大,二極管的反向恢復電壓就越高,增大了過壓失效的風險。另外一個影響就是會導致反向恢復電流和電壓的振蕩,振蕩會影響系統的穩定性并且可能通過米勒電容反饋到門極。
圖9.4 dV/dt Vs. ton圖9.4為CM1200HC-66H的二極管導通時間與反向恢復電壓dv./dt的關系,可以看到在導通脈寬小于10us的情況下,dv/dt急劇增大。
過電流失效的故障點集中于綁定線區域,因為電流流向是從硅片背部的集電極到綁定線部位的發射極,綁定線與硅片的連接處承受很大的熱應力而導致該處熔斷。
過溫失效的故障點靠近芯片中心,因為該區域發熱最嚴重。
圖9.6 過溫失效
-
散熱設計不完善。
-
散熱脂涂抹不合理。如果散熱脂涂抹過薄或者過厚,會造成HVIGBT的殼與散熱器的熱阻增大,進而影響散熱效果。
-
額定工作電流過大。
-
門極驅動電壓不足導致的飽和壓降上升。流過相同的集電極電流,門極驅動電壓越小,HVIGBT的VCE(sat)越大,進而損耗越大。
-
HVIGBT開關頻率過大或者過小導致損耗增加。
-
變流器輸出頻率過小。由于結-殼和殼-散熱器的瞬態熱阻原因,變流器輸出頻率越低(也即通態時間越長),HVIGBT的結溫波動范圍越大,如果最大結溫超過最大允許結溫可能會導致HVIGBT損壞。
圖9.7為RBSOA失效的內部芯片圖,典型特征為貫穿芯片的熔洞。IGBT先失效,二極管二次失效。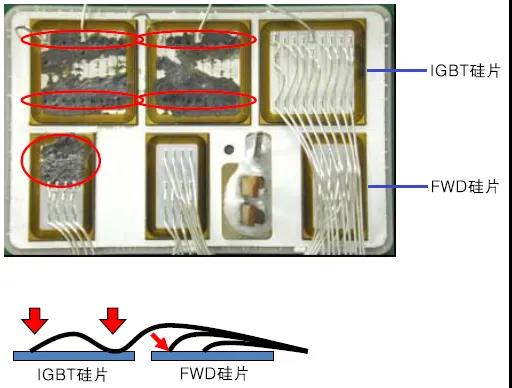
圖9.7 RBSOA失效芯片圖圖9.8是CM1500HC-66R在VCC=2500V & IC=6078A的條件下 RBSOA 失效的案例,超過CM1500HC-66R規格書規定的電流限制是3000A。圖9.9為RRSOA失效的內部芯片圖。二極管先失效,IGBT二次失效。
圖9.9 RRSOA失效芯片圖圖9.10是CM1500HC-66R在VCC=2500V & IC=1500A的條件下 RRSOA失效的案例,試驗中為了達到較大的峰值功率,設置Rg=0Ω,同時增大母線雜散電感,可以看到反向恢復電壓遠遠超過3300V。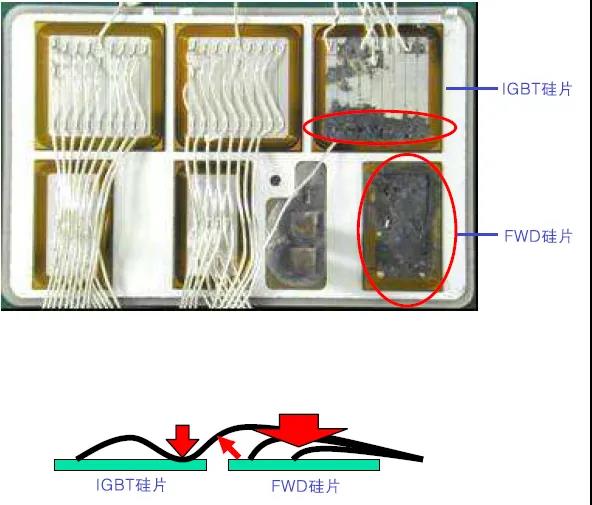
圖9.10 RRSOA失效波形圖圖9.11為SCSOA失效的內部芯片圖。僅有IGBT硅片失效。
圖9.11 SCSOA失效硅片圖
功率器件都有一個壽命期限,HVIGBT也不例外。由于不同材料之間溫度變化而產生的應力是決定功率器件壽命的因素之一。如圖9.12所示,為HVIGBT的內部結構圖,不同材料的熱膨脹系數不同。如圖中上面紅色圓圈所示,由于鋁線和硅片熱膨脹系數不同,模塊工作時結溫發生變化會導致它們之間產生機械應力,這種應力循環積累會使硅片與鋁綁定線結合處發生龜裂而最終導致完全破壞,這種損壞模式稱為功率循環壽命失效。同樣如圖中下面的紅色圓圈所示,由于功率模塊外殼溫度的變化,模塊絕緣基板和底板的膨脹系數不同導致它們之間的焊接層發生應力變形,該應力變形累積的結構就是焊接層龜裂,使得結殼熱阻增加導致熱破壞。但是同時,由于熱阻增加,結溫變化增加,功率循環耐受能力降低最終導致跟功率循環失效相同的綁定線剝離。
圖9.12 HVIGBT剖面構造圖功率循環壽命的損壞點為綁定線和硅片之間連接點。功率循環壽命損壞的初期表現是連接點的開裂。經過長時間運行后,最終綁定線會從硅片上脫落下來。如圖9.13所示。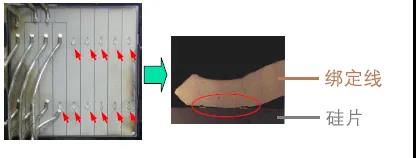
圖9.13 功率循環失效
在功率模塊殼溫變化幅度大的工作模式下,由于絕緣基板和底板的熱膨脹系數不同,絕緣基板和底板之間的焊接層將產生應力。這種應力的累積將會使焊接層產生裂紋。這種失效模式稱為熱循環失效。熱循環壽命的損壞點為絕緣基板和底板之間焊接層。熱循環壽命失效的初期表現是該焊接層從邊緣部分的開裂,并逐步向焊接層的中央發展。如圖9.14所示。三菱電機認為當開裂比例大于50%時,該HVIGBT的熱循環壽命已經到期,器件已經損壞。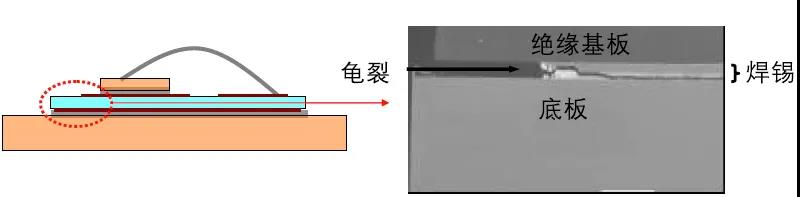
圖9.14 熱循環失效圖9.15顯示了某HVIGBT在長期運行后焊接層開裂的狀況。該圖是使用超聲波掃描顯微鏡(SAT, scanning acoustic tomography)得到的。其中,紫色三角為已經開裂部分。由于器件發熱的不均勻和焊接層自身的差異,開裂程度并不完全一致。另外,由于該焊接層的開裂也會影響硅片的散熱,推高硅片的運行結溫,加速HVIGBT的功率循環壽命損壞。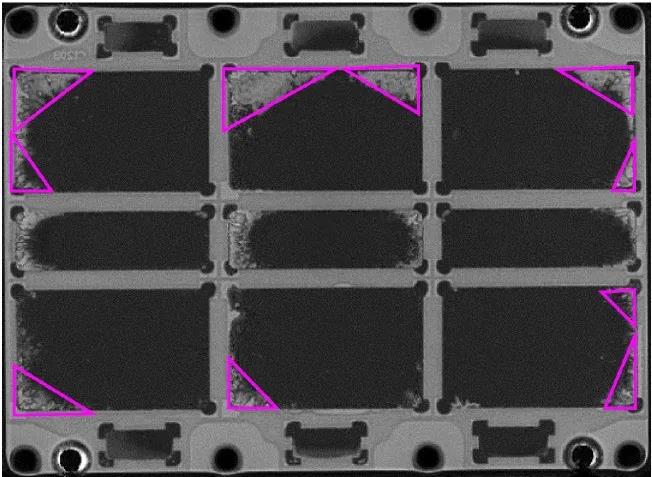
圖9.15 某HVIGBT在長期運行后焊接層開裂狀況
HVIGBT模塊的安裝請參考本書第10章相關內容,安裝不當可能會造成損壞。
(1) 導熱硅脂涂抹不均勻,涂抹量過少或者過多。如果硅脂涂抹不當,會造成HVIGBT底板與散熱器之間的熱阻增大(請參考10.2.1相關內容),增加HVIGBT模塊過溫失效的風險。
(2) 安裝螺絲太長或者太短。如圖9.16所示,過長的螺絲可能會導致封裝破損或者電氣短路。過短的螺絲會造成接觸不良和熱應力集中。
圖9.16 過長的螺絲損壞IGBT(3)安裝螺絲的扭矩沒有按照推薦的扭矩。會導致接觸不良和應力集中。
在實際應用中,HVIGBT的電壓沒有超過其額定電壓,但是仍然有失效的情況,LTDS(Long Term DC Stability)失效是其中的一種可能原因。HVIGBT在高壓條件下工作時會出現宇宙射線輻射引起的失效,屬永久失效。通常這種失效的失效點是隨機的,但是在大多數情況下,失效點是靠近硅片的邊緣區域,如下圖所示: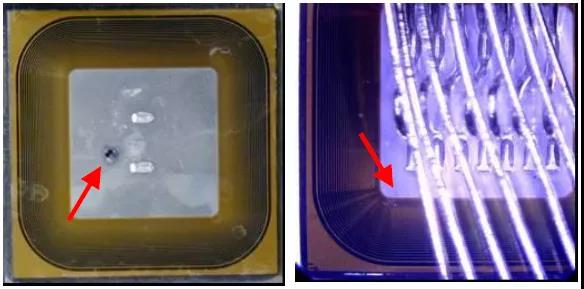
圖9.18 LTDS失效宇宙射線一般來講,指的是來自于宇宙中的一種具有能量的帶電粒子流。宇宙射線帶來的失效率會隨著使用電壓、溫度、輻射度、海拔以及經緯度有關。HVIGBT的集電極和發射極之間的電壓越高,或者海拔越高,由宇宙射線引起的失效率越高。相反,溫度越高,由宇宙射線引起的失效率越低。
圖9.19 CM1600HC-34H的LTDS曲線圖9.19給出了CM1600HC-34H的LTDS曲線,紅色為海拔4000米的曲線,黑色為海平面的曲線。從圖中可以看出,在直流電壓1100V時,海拔為海平面時失效率為20FIT,海拔為4000米時,失效率為200FIT。如果希望還海拔4000米處維持相同的失效率,需要將直流母線電壓降至1030V。







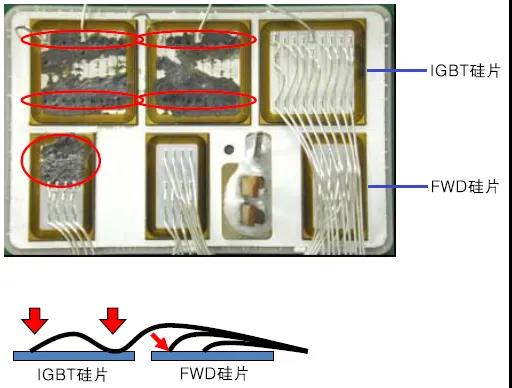


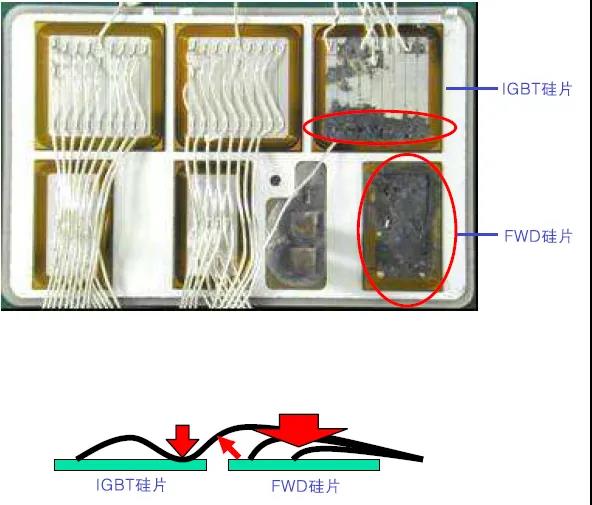


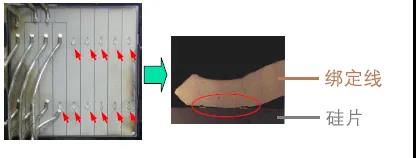
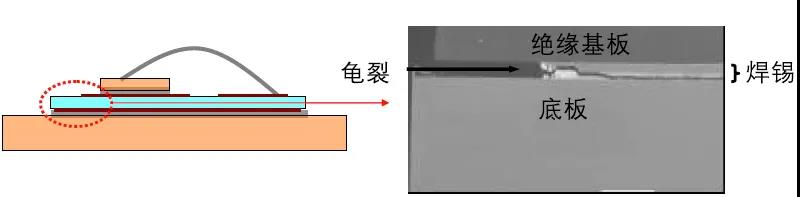
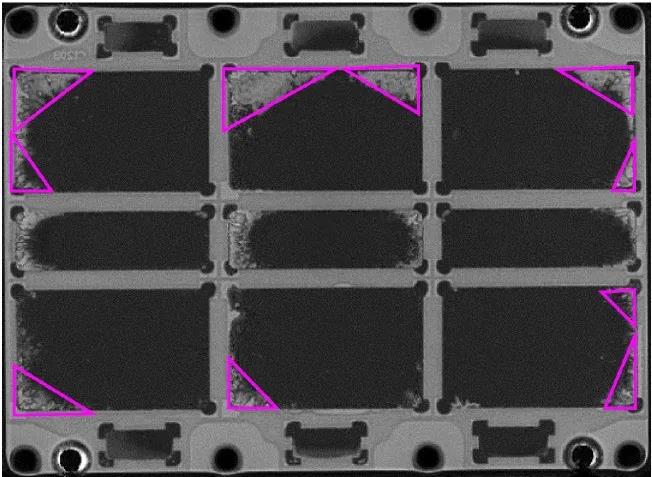

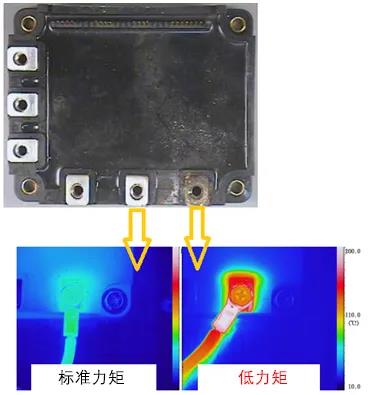
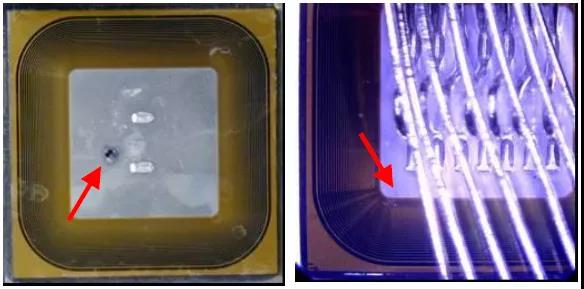











共0條 [查看全部] 網友評論